- TEL:
- +81-3-5462-4015
- FAX:
- +81-3-5462-4883
※营业时间 工作日9:00~17:40(日本时间)
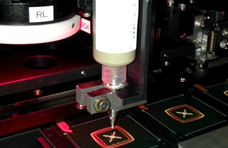
|
我们在维持日本市场占有率第一的同时,也在积极开拓海外市场。 生产工厂
研究所
|
CRM系列为单组分键合胶。作为半导体芯片键合材料,本品适用于通用半导体组件、薄型、大型半导体组件以及BGA、CSP等尖端半导体组件,可提高其可靠性。此外,还被广泛用作LED高散热芯片键合材料。
与IC芯片、引线框架、有机基板的粘合、芯片层压用途
与LED芯片、基板、框架的粘合用途
| 型号 | 特点 | 主要用途 |
|---|---|---|
| CRM-1030系列 | 炉内硬化通用型 | SOT、DIP、SO、PLCC、QFP |
| CRM-1060系列 | 快速硬化型 | SOT、DIP、SO、PLCC、QFP |
| CRM-1070系列 | 低应力型 | DIP、SO、PLCC、QFP、L/TQFP、TSOP、LF CSP |
| CRM-1080系列 | 高密著、高導熱型 | 小Chip(SOT、LED等) |
| CRM-1100系列 | 绝缘型 | SOT、DIP、SO、PLCC、QFP、L/TQFP、TSOP、LF CSP |
| CRM-1200系列 | 高導熱型, TIM | DIP、SO、PLCC、QFP、L/TQFP、TSOP |
| CRM-1500系列 | 層壓基板型 | PBGA、FPBGA、FCBGA |
| CRM-1700系列 | 自由基硬化,低應力型 | DIP、SO、PLCC、QFP、L/TQFP、TSOP、LF CSP |
| CRM-1800系列 | 超散熱型,Ag燒結 | Discrete、SO、 QFP、L/TQFP、LF CSP |
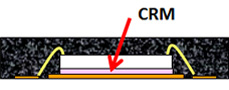
引线框架封装 |
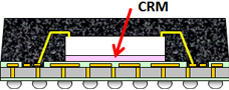
面阵列封装 |