产品介绍

|
以下为半导体封装基板用材料的产品信息。 生产工厂
|
特点
具有热膨胀系数低、高Tg、低Ra表面粗糙度、高剥离强度等特性,可满足高可靠性、纤薄化、高密度封装等要求。
用途
电子、电器领域
主要用于半导体封装基板、模块基板等要求具备高可靠性、纤薄等特点的产品
规格参数
| Unit | LαZ | |
|---|---|---|
| BLα-3700GS | ||
| Tg(by DMA) | ℃ | 200 |
| Tg(by TMA) | ℃ | 180 |
| CTE1 | ppm/℃ | 35 |
| CTE2 | ppm/℃ | 120 |
| Tensile Modulus(R.T.) | G Pa | 5 |
| Tensile Modulus(250℃) | G Pa | 0.2 |
| Dielectric constant | (1GHz) | 3.1 |
| Dielectric Dissipation Factor | (1GHz) | 0.012 |
| Moisture Absorption | wt% | 1.0 |
| (0.2t)(PCT-2hr/121℃) |



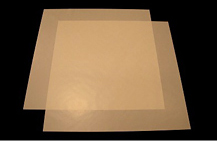

 咨询·资料请求
咨询·资料请求